IC开封介绍
芯片开封,也叫芯片开盖,去胶,IC Decap. 是使用实验处理手段将芯片的封装材料去除的过程。
常用化学腐蚀和激光开封两种方式进行。
机械开封:使用钳子等方式将封装材料去除,一般是应用在较大颗的芯片上。
化学腐蚀开封 : 在IC封装胶体材料上,利用化学溶液,将封装材料腐蚀掉一个区域,使打线或晶粒裸露。
激光开封 : 利用激光去除IC封装胶体材料,和一般化学开封相比,激光开封定位更精准,与化学腐蚀开封搭配使用,可以减少化学药剂和样品接触的时间,开封更加精准,降低实验的失败率。
通常为失效分析的样品处理步骤,后续实验可能是:外观异常检查 / FIB / EMMI / Wire Bonding等。
开封的方法
一般的有化学(Chemical)开封、机械(Mechanical)开封、激光(Laser)开封、Plasma Decap
开封实验室:Decap实验室可以处理几乎所有的IC封装形式(COB.QFP.DIP SOT 等)、打线类型(Au Cu Ag)。高分子的树脂体在热的浓硝酸(98%)或浓硫酸作用下,被腐蚀变成易溶于丙酮的低分子化合物,在超声作用下,低分子化合物被清洗掉,从而露出芯片表层。
开封方法一:在加热板上加热,温度要达100-150度,将芯片正面方向向上,用吸管吸取少量的发烟硝酸(浓度>98%)。滴在产品表面,这时树脂表面起化学反应,且冒出气泡,待反应稍止再滴,这样连滴5-10滴后,用镊子夹住,放入盛有丙酮的烧杯中,在超声波清洗机中清洗2-5分钟后,取出再滴,如此反复,直到露出芯片为止,最后必须以干净的丙酮反复清洗确保芯片表面无残留物。
开封方法二:将所有产品一次性放入98%的浓硫酸中煮沸。这种方法对于量多且只要看芯片是否破裂的情况较合适。缺点是操作较危险。要掌握要领。
应用领域
模拟集成芯片、数字集成芯片、混合信号集成芯片、双极芯片和CMOS芯片、信号处理芯片、功率芯片、直插芯片、表面贴装芯片、航天级芯片,汽车级芯片,工业级芯片、商业级芯片等。
参考标准
GB/T 37720-2019 识别卡 金融IC卡芯片技术要求
GB/T 37045-2018 信息技术 生物特征识别 指纹处理芯片技术要求
GB/T 4937.19-2018 半导体器件 机械和气候试验方法 第19部分:芯片剪切强度
GB/T 36613-2018 发光二极管芯片点测方法
GB/T 36356-2018 功率半导体发光二极管芯片技术规范
GB/T 33922-2017 MEMS压阻式压力敏感芯片性能的圆片级试验方法
GB/T 33752-2017 微阵列芯片用醛基基片
GB/T 28856-2012 硅压阻式压力敏感芯片
DB35/T 1403-2013 照明用多芯片集成封装LED筒灯
EIA EIA-763-2002 自动装配用裸芯片和芯片级封装,使用8 mm和12 mm载体带捆扎
DLA DSCC-DWG-01002 REV E-2002 2512型1.5瓦特(MELF)单位陶瓷封装胶卷芯片固定电阻器

化学开封效果
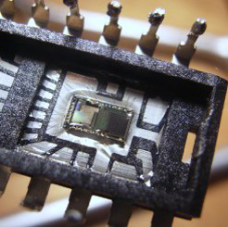
激光开封效果
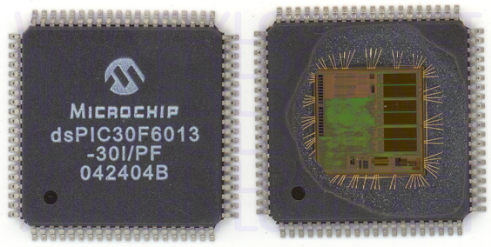
开封前后的对比
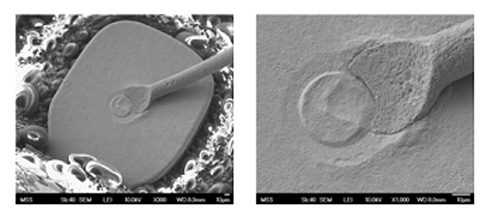
开封后用SEM观测焊点连接情况

仪准酸开封机

仪准ADVANCED PST-2000



